| News丗僯儏乕僗懍曬 | 2002擭8寧5擔丂06:23 PM 峏怴 |
嬌敄僂僄僴乕傕旕愙怗偱崅懍愗抐丂昹徏儂僩僯僋僗偑怴媄弍傪奐敪
昹徏儂僩僯僋僗偼8寧5擔丄僔儕僐儞僂僄僴乕偐傜僠僢僾傪愗傝弌偡僟僀僔儞僌岺掱偱丄僂僄僴乕偵愙怗偣偢偵崅懍偵愗抐偡傞乽僗僥儖僗僟僀僔儞僌乿乮SD乯媄弍傪奐敪偟偨偲敪昞偟偨
丂昹徏儂僩僯僋僗偼8寧5擔丄僔儕僐儞僂僄僴乕偐傜僠僢僾傪愗傝弌偡僟僀僔儞僌岺掱偱丄僂僄僴乕偵愙怗偣偢偵崅懍偵愗抐偡傞乽僗僥儖僗僟僀僔儞僌乿乮SD乯媄弍傪奐敪偟偨偲敪昞偟偨丅恘傪巊偭偨廬棃曽朄偵斾傋崅懍偐偮岠棪椙偔僟僀僔儞僌偑壜擻側忋丄嬌敄僂僄僴乕傪巊梡偟偨師悽戙敿摫懱偺幚梡壔偵傕偮側偑傞丅
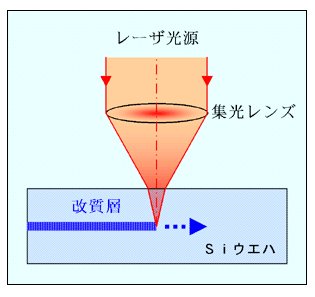
僗僥儖僗僟僀僔儞僌偺尨棟
丂SD偱偼丄僂僄僴乕偵懳偟偰摟柧側嬤愒奜儗乕僓乕傪徠幩偟偰僂僄僴乕撪晹偵廤岝偝偣傞丅儗乕僓乕岝偺嫮搙傪崅傔偨応崌偵敪惗偡傞乽懡岝巕媧廂乿尰徾偵傛傝丄徠幩偟偨晹暘偑夵幙憌傪宍惉偡傞丅夵幙憌傪悅捈偵惉挿偝偣傞偙偲偱僂僄僴乕傪妱傝丄僠僢僾傪暘妱偡傞丅

丂恘偱愗抐偡傞僽儗乕僪僟僀僔儞僌乮BD乯偵斾傋栺5攞崅懍側枅昩300儈儕偺愗抐偑壜擻偵側傞忋丄愗抐傇傟偑側偄偨傔僠僢僾娫嫍棧傪嵟彫1兪儊乕僩儖偵傑偱嫹僺僢僠壔偱偒丄僠僢僾愗傝弌偟岠棪傪岦忋偱偒傞丅僠僢僺儞僌傪傢偢偐偵梷偊傞偙偲偱曕棷傑傝傕岦忋丄姰慡僪儔僀僾儘僙僗側偨傔弮悈偵傛傞愻忩岺掱側偳傕晄梫偵側傝丄惢憿僐僗僩傪嶍尭偱偒傞丅
丂愊憌偵傛傝戝梕検壔傪幚尰偡傞師悽戙儊儌儕側偳偱偼100兪儊乕僩儖埲壓偺敄宆僂僄僴乕傪巊梡偡傞丅BD偱偼岤偝50兪儊乕僩儖偑尷奅偲偝傟偰偒偨偑丄SD側傜30兪儊乕僩儖偺嬌敄僂僄僴乕傕崅懍偵愗抐壜擻偲偄偆丅
丂傑偨擔棫惢嶌強偑奐敪偟偨0.4儈儕妏偺挻彫宆僠僢僾乽儈儏乕僠僢僾乿乮2001擭6寧29擔偺婰帠嶲徠乯偵揔梡偟偨応崌丄8僀儞僠僂僄僴乕1枃偐傜BD偵斾傋栺2枩5000屄傕懡偔愗傝弌偡偙偲偑壜擻偩偲偄偆丅
丂2003擭弔偵傕SD傪搵嵹偟偨僟僀僔儞僌憰抲傪惢昳壔偡傞寁夋丅傑偨怴媄弍傪敿摫懱儊乕僇乕傗惢憿憰抲儊乕僇乕偵峀偔岞奐丄媄弍採実傗儔僀僙儞僗嫙梌傪恑傔傞丅
娭楢婰帠
娭楢儕儞僋
[ITmedia]
Copyright © ITmedia, Inc. All Rights Reserved.

