| News:ニュース速報 | 2001年12月4日 04:48 PM 更新 |
富士通,チップを25μメートルに薄化する新加工技術
富士通は12月4日,半導体シリコンチップの厚さを25μメートルと現在の約4分の1に薄くできる加工技術を開発したと発表した。複数のチップを積み重ねるスタックMCPを薄型化できる。
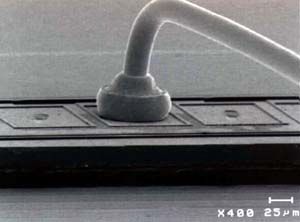
半導体ウエハーの裏面研削を行う際に,研削するウエハーをサポート治具に固定,研削中に発生する反りを矯正して薄化を行う技術を採用。チップの回路面を均一に固定するためのサポート治具の形状や材質,工法を開発した。またダイシング後にチップを取り出すピックアップ方式を改良するなどし,薬液を使わずに薄化加工することが可能になったという。
MCPなどでは100μメートル以下,ICカードチップでは50μメートル以下にチップを薄化する必要があるが,薬液を使わず研削で100μメートル以下にするとウエハーのひび割れが生じる問題があった。新技術では研削により薄化が可能なため,薬液を使用した場合に比べ加工期間の短縮や設備コストの削減につながる上,廃薬液が出ないため環境にも配慮できる。
関連リンク
![]() ニュースリリース
ニュースリリース
[ITmedia]
Copyright © ITmedia, Inc. All Rights Reserved.

