| News | 2003年12月3日 10:08 PM 更新 |
SEMICON JAPAN 2003のキーワードは「300ミリウエハー」に「65ナノプロセス」(2/2)
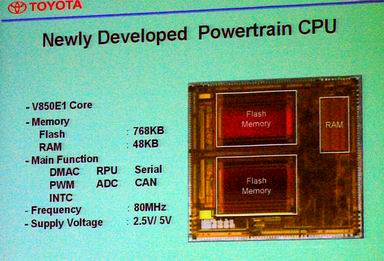
PRIUSに搭載されているCPUは、その担当する機能ごとに複数用意されている。エンジン制御のために開発された「Powertrain CPU」はV850E1をコアにしており、動作クロック80MHz、駆動電圧2.5V(もしくは5V)。「エンジン制御用なので高精度なCPUが必要になる。処理も複雑なため、メモリは768Kバイトと大容量になっている」(小野氏)

こちらはブレーキシステム制御用に開発された「Brake System CPU」。TX19をコアにして、駆動クロック32MHz、駆動電圧3.3V(もしくは5V)。このほかにもトヨタでは、ハイブリッド制御用の基板も開発しているが、実装スペースを節約するために集積化した「IPM」というワンチップモジュールにして自社工場で内製している。このように半導体モジュールの開発製造も自社内部で行うことで、「高品質、高いコストパフォーマンス、開発期間短縮を実現する」(小野氏)
微細化の最重要課題は「High-K」問題
リリースベースでは、90ナノプロセスのCPUがそろそろ登場しそうな雰囲気になってきたが、SEMICON会場では、その一歩先の65ナノプロセス時代が本格的に到来したかのように、65ナノ対応製造装置の展示が多くのベンダーで行われていた。会場展示と並行して12月3日から5日まで行われている「SEMIテクノロジシンポジウム 2003」でも、初日のSession1「先端デバイス−65nm世代へ向けての先端デバイス−」で、プロセスの微細化に関連した最新技術が紹介されていた。
この中で、「重要な問題」として取り上げられていたのが「High-Kゲート絶縁体」にまつわるテーマ。プロセスの微細化で大きな問題となりつつある「リーク電流」を削減させるキーテクノロジーとして最近注目されているが、まだ「決定的」な方法が完成していない分野でもある。先日インテルが発表した「メタルゲート」もHigh-Kの技術を完成させるために生み出された解決策の一つ。
インテルがメタルゲートを大々的に発表したため、部外者には「High-Kを実現するなら、従来のポリシリ系ゲートではなくメタルゲートが有望」というイメージができてしまったが、研究者の間では、ポリシリ系ゲートでも問題なく使えるHigh-K素材の開発にも取り組んでいる。
今回のセッションで「先端CMOS用High-Kゲート絶縁膜技術」の講師を勤めた北島洋氏(半導体先端テクノロジーズ第一研究部)は、現在ポリシリ系ゲート用High-K素材として注目されている「HfSiO」(ハフニウムシリケート)と「HfAlO」(ハフニウムアルケート)の開発状況について紹介している。
どちらの方法を取るにしても、従来絶縁膜として使われていたSiO2に匹敵する電気特性(膜厚2ナノメートルで、低リーク電流とSiO2に匹敵する電気移動度、など)を実現したうえで、ポリシリ系ゲートでHigh-Kを使う場合に問題になる「膜の結晶化」や「相分離」「フェノン振動による電子移動度の低下」を抑えなければならない。
HfSiOをHigh-K膜に採用した場合、膜の生成方法の改良などにより、同じ膜厚でもSiO2に匹敵する高い移動度を発揮することが確認されている。二酸化ハフニウムと比べて下地Siとの反応も抑制できるメリットもあるが、低電圧動作時においてドレイン電流が少ししか流れない欠点も判明している(より正確に言うとpFETにおけるVt制御が困難で、n-FETとのバランスが悪い)。HfSiOについてはこの解決が最も大きな問題となっているようだ。
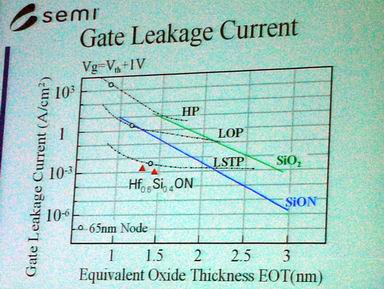
65ナノプロセスにおける膜厚(EOTの値)とリーク電流の関係。緑色のSiO2と比べても赤い三角でプロットされたHfSiONのリーク電流は低い値に抑えられている
HfAlOをHigh-K膜に採用した場合、HfSiOと比べて移動度が低くなることが分かっている。これは下地のSiO2にアルミを乗せると、SiO2が還元することで移動度が低下するため。SiO2の還元を抑制するために窒素濃度が高いSiONを下地に採用すると、多少改善されるもののそれでもHfSiONより低い移動度にとどまっている。現在では下地に窒素を導入する技術が未完成なので、この技術の完成がHfAlOをHigh-Kで使うためには必須となる。
このようにいろいろと不利な点が目立つHfAlOであるが、HfSiOの欠点であった低電圧駆動時におけるドレイン電流の特性が良好で、さらに成膜時に、ある程度制御ができるといった捨てがたいメリットがある。
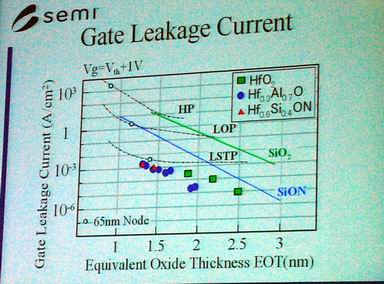
先ほどのグラフにHfAlOのデータを青い丸でプロット。リーク電流はHfSiOと同程度に抑えられるが、「窒素の導入などで膜厚を薄くするのが難しい」(北島氏)
HfSiOではp-FETにおけるVtの制御技術の確立。HfAlOでは下地のSiO2に窒素を導入する技術の確率。以上のように解決すべきポイントは絞られているが、その解決の時期については今のとこと明確な答えは出ていない。製造装置は65ナノ対応がいち早く進んでいるようだが、やはり「リーク電流」を解決するキーテクノジー問題が、65ナノプロセス実現の「関門」として待ち構えているようだ。
関連記事
関連リンク
[長浜和也, ITmedia]
Copyright © ITmedia, Inc. All Rights Reserved.
前のページ | 2/2 | 最初のページ

